ZHCSJO5D April 2020 – April 2021 DRV8889-Q1
PRODUCTION DATA
- 1 特性
- 2 應用
- 3 說明
- 4 修訂歷史記錄
- 5 引腳配置和功能
- 6 規格
- 7 詳細說明
- 8 應用和實施
- 9 電源建議
- 10布局
- 11器件和文檔支持
- 12機械、封裝和可訂購信息
封裝選項
機械數據 (封裝 | 引腳)
散熱焊盤機械數據 (封裝 | 引腳)
訂購信息
8.2.4.3 HTSSOP 封裝的熱參數
RθJA(結至環境熱阻)和 ΨJB(結至電路板特征參數)等熱參數的變化很大程度取決于 PCB 類型、封裝類型、銅厚度和銅焊盤面積。
圖 8-15 和圖 8-16 展示了采用 HTSSOP 封裝的 2 層 PCB 銅焊盤區域的 RθJA(結至環境熱阻)和 ΨJB(結至電路板特征參數)差異。如這些曲線所示,當PCB的銅厚度越厚和銅焊盤面積越大,熱阻就越低。
類似地,圖 8-17 和圖 8-18 展示了采用 HTSSOP 封裝的 4 層 PCB 銅焊盤區域的 RθJA 和 ΨJB 差異。
注:
熱參數(RθJA[結至環境熱阻]和 ΨJB[結至電路板特征參數])是基于環境溫度為 25°C、高側和低側 FET 之間均勻耗散 2W 功率這一情況計算得出的。計算得出的熱參數考慮了功率 FET 實際位置處的功率耗散,而不是平均估計值。
熱參數很大程度取決于外部條件,如海拔高度、封裝幾何形狀等。更多詳細信息,請參閱應用報告。
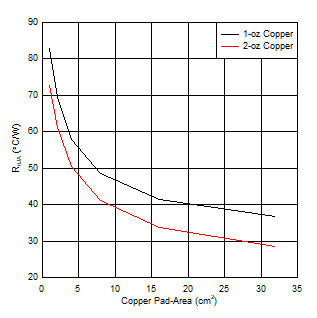 圖 8-15 2 層 PCB 結至環境熱阻 (RθJA) 與覆銅區的關系
圖 8-15 2 層 PCB 結至環境熱阻 (RθJA) 與覆銅區的關系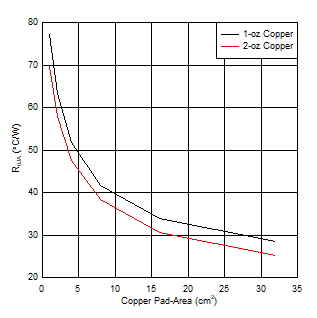 圖 8-17 4 層 PCB 結至環境熱阻 (RθJA) 與覆銅區的關系
圖 8-17 4 層 PCB 結至環境熱阻 (RθJA) 與覆銅區的關系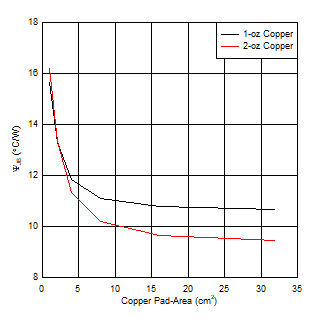 圖 8-16 2 層 PCB 結至電路板特征參數 (ΨJB) 與覆銅區的關系
圖 8-16 2 層 PCB 結至電路板特征參數 (ΨJB) 與覆銅區的關系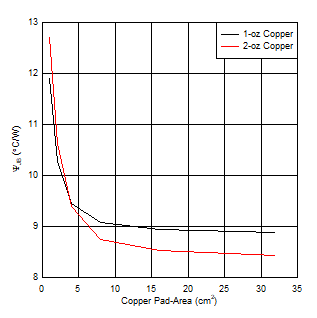 圖 8-18 4 層 PCB 結至電路板特征參數 (ΨJB) 與覆銅區的關系
圖 8-18 4 層 PCB 結至電路板特征參數 (ΨJB) 與覆銅區的關系