ZHCSUO9A February 2024 – July 2025 DRV8262-Q1
PRODUCTION DATA
8.1.1 熱性能
數據表指定的結至環境熱阻 RθJA 主要用于比較各種驅動器或者估算熱性能。不過,實際系統性能會比此值更好或更差,具體情況取決于 PCB 層疊、布線、過孔數量以及散熱焊盤周圍的銅面積。驅動器驅動特定電流的時間長度也會影響功耗和熱性能。本節介紹了如何設計穩態和瞬態溫度條件。
本節中的數據是按如下標準仿真得出的:
HTSSOP(DDW 封裝)
- 2 層 PCB(尺寸 114.3mm x 76.2mm x 1.6mm),標準 FR4,1oz(35mm 銅厚度)或 2oz 銅厚度。散熱過孔僅存在于散熱焊盤下方(13 x 5 散熱過孔陣列,1.1mm 間距,0.2mm 直徑,0.025mm 銅鍍層)。
- 頂層:HTSSOP 封裝尺寸和銅平面散熱器。頂層銅面積在模擬中有所不同。
- 底層:接地層通過驅動器的散熱焊盤下方的過孔進行熱連接。底層銅面積隨頂層銅面積而變化。
- 4 層 PCB(尺寸 114.3mm x 76.2mm x 1.6mm),標準 FR4。外層平面具有 1oz(35mm 覆銅厚度)或 2oz 覆銅厚度。內層平面保持在 1oz。散熱過孔僅存在于散熱焊盤下方(13 x 5 散熱過孔陣列,1.1mm 間距,0.2mm 直徑,0.025mm 銅鍍層)。
- 頂層:HTSSOP 封裝尺寸和銅平面散熱器。頂層銅面積在模擬中有所不同。
- 中間層 1:GND 平面通過過孔熱連接至散熱焊盤。接地平面的面積隨頂部銅面積的變化而變化。
- 中間層 2:電源平面,無熱連接。電源平面的面積隨頂部銅面積的變化而變化。
- 底層:信號層通過來自頂部和內部 GND 平面的過孔拼接進行熱連接。底層散熱焊盤的尺寸與頂層覆銅區相同。
圖 8-1 展示了 DDW 封裝的模擬電路板示例。表 8-1 顯示了每次仿真時使用的不同板尺寸。
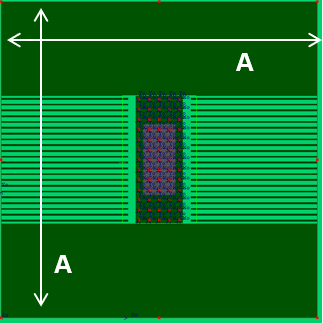 圖 8-1 DDW PCB 模型頂層
圖 8-1 DDW PCB 模型頂層表 8-1 DDW 封裝的尺寸 A
| 銅面積 (cm2) | 尺寸 A(mm) |
|---|---|
| 2 | 19.79 |
| 4 | 26.07 |
| 8 | 34.63 |
| 16 | 46.54 |
32 | 63.25 |