ZHCY219 March 2025 DRV7308
電源效率
對于設計高功率解決方案而言,效率是最重要的指標。雖然 TI 可以提供分立式場效應晶體管 (FET) 和穩壓器,但在許多電源設計中,將 FET 與控制器集成非常重要。早期的設計依賴于許多金引線鍵合(如 圖 5 所示)來最大限度地降低 FET 中的電阻,但導線成本有時會超過封裝中芯片的成本。為了降低成本并提高功耗和性能,TI 開發了兼容銅引線的硅技術。
 圖 5 盡管 HTSSOP 封裝可能只使用幾個外部引腳,但為了滿足集成 FET 在電流和電阻方面的要求,仍需要幾十條粗規格的鍵合線。
圖 5 盡管 HTSSOP 封裝可能只使用幾個外部引腳,但為了滿足集成 FET 在電流和電阻方面的要求,仍需要幾十條粗規格的鍵合線。隨著功率密度的提高,TI 采用了垂直 FET 技術和銅夾(如 圖 6 所示),以便在高電流封裝中保持 FET 的低電阻。
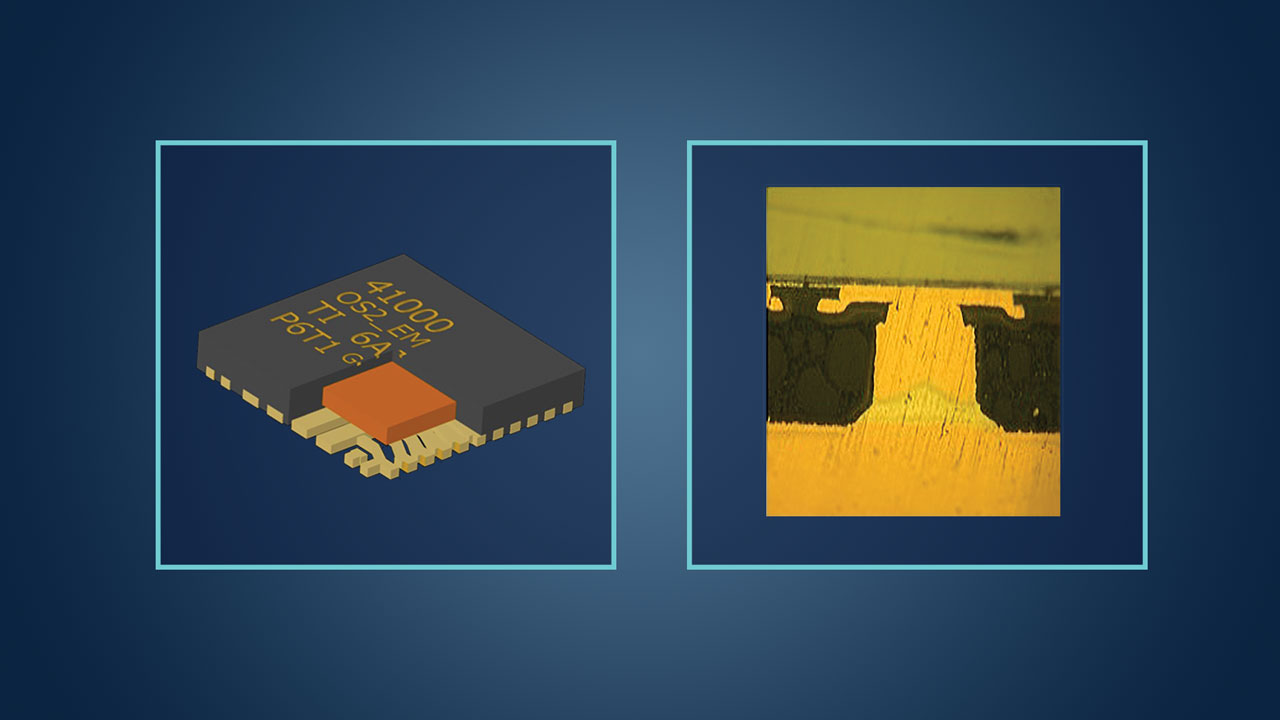 圖 6 與圖 5 所示的多根鍵合線相比,高電流封裝中使用銅夾可降低電阻。
圖 6 與圖 5 所示的多根鍵合線相比,高電流封裝中使用銅夾可降低電阻。半導體制造領域的創新包括:在同一芯片上集成了 CMOS 和雙極晶體管技術,促進了具有集成控制器的高性能 FET 的發展。為了滿足低電阻和先進控制器的要求,TI 開發了 HotRod? 技術,該技術使用低電阻銅凸點將 PCB 上的電源電路緊密連接到芯片上,如 圖 7 所示。
 圖 7 在封裝中,銅凸點直接將裸晶連接到銅,從而實現從 FET 幾乎直接到 PCB 的路徑。
圖 7 在封裝中,銅凸點直接將裸晶連接到銅,從而實現從 FET 幾乎直接到 PCB 的路徑。對于需要采用業界通用封裝尺寸的設計人員而言,TI 的增強型 HotRod QFN 封裝技術可提供在整個封裝內路由信號的靈活性(如 圖 8 所示),同時保持超低電阻的連接,從而高效地為終端設備供電。
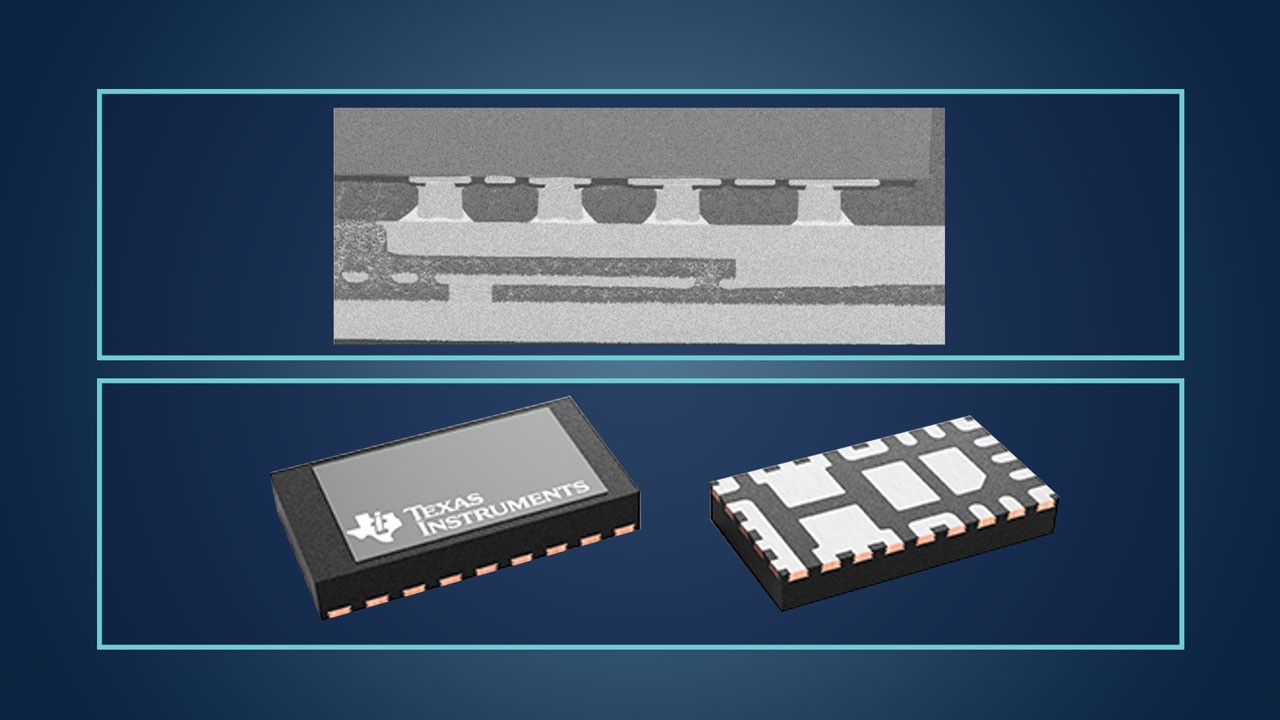 圖 8 增強型 HotRod 技術將器件連接到厚銅布線層。這種方法可使 PCB 的電阻非常低,同時允許靈活地使用散熱焊盤或匹配標準化封裝尺寸。
圖 8 增強型 HotRod 技術將器件連接到厚銅布線層。這種方法可使 PCB 的電阻非常低,同時允許靈活地使用散熱焊盤或匹配標準化封裝尺寸。有許多應用(例如電子手寫筆)都需要極度微型化。如圖 9 和圖 10 所示,將電感器集成到封裝中有助于解決小尺寸限制問題,以便設計人員能夠在過去不適合的地方實現高效率開關穩壓器。除了實現微型化外,TI 的 MicroSiP? 封裝(如 圖 9 和 圖 10 所示)還旨在通過將芯片緊密耦合到 PCB 內的較厚銅層,從而將所有模塊熱量傳遞到 PCB。
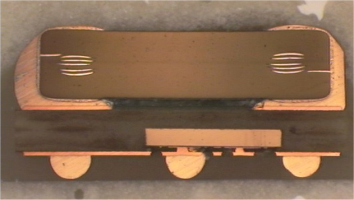 圖 9 采用 MicroSiP? 封裝的 TI TPS82670 降壓轉換器的橫截面。嵌入式硅電路位于其電感器下方
圖 9 采用 MicroSiP? 封裝的 TI TPS82670 降壓轉換器的橫截面。嵌入式硅電路位于其電感器下方 圖 10 采用 MicroSiP 封裝的 TPS82670 降壓轉換器的頂視圖和底視圖。
圖 10 采用 MicroSiP 封裝的 TPS82670 降壓轉換器的頂視圖和底視圖。設計工程師還需要利用更大功率的模塊,將高效電感器直接集成到封裝中,同時提高功率密度的限制。TI 新的電源模塊采用 MagPack? 技術,這是我們新推出的專有集成磁性封裝,可以提高功率密度和效率、降低溫度和輻射,同時最大限度地減小布板空間并降低系統功率損耗。采用 MagPack 技術的模塊(例如 TPSM82866A 6A 降壓轉換器)的功率密度接近 1A/1mm2,如 圖 11 和 圖 12 所示。
 圖 11 采用 2.3mm x 3mm MagPack 封裝的 TPSM82866A 6A 降壓轉換器可實現 28mm2 的總解決方案尺寸。
圖 11 采用 2.3mm x 3mm MagPack 封裝的 TPSM82866A 6A 降壓轉換器可實現 28mm2 的總解決方案尺寸。 圖 12 采用 MagPack 技術的電源模塊比同類 3A 和 6A 模塊小 20%。
圖 12 采用 MagPack 技術的電源模塊比同類 3A 和 6A 模塊小 20%。因具有高功率密度并能夠在更高的電壓下運行,氮化鎵 (GaN) 功率級在電池充電和太陽能等市場中越來越受歡迎。如 圖 13 所示,TI 的 100V LMG3100 GaN FET 采用增強型 HotRod 封裝技術,能夠在接近輸入電壓的位置放置散熱過孔,同時電源焊盤可優化封裝的功耗。
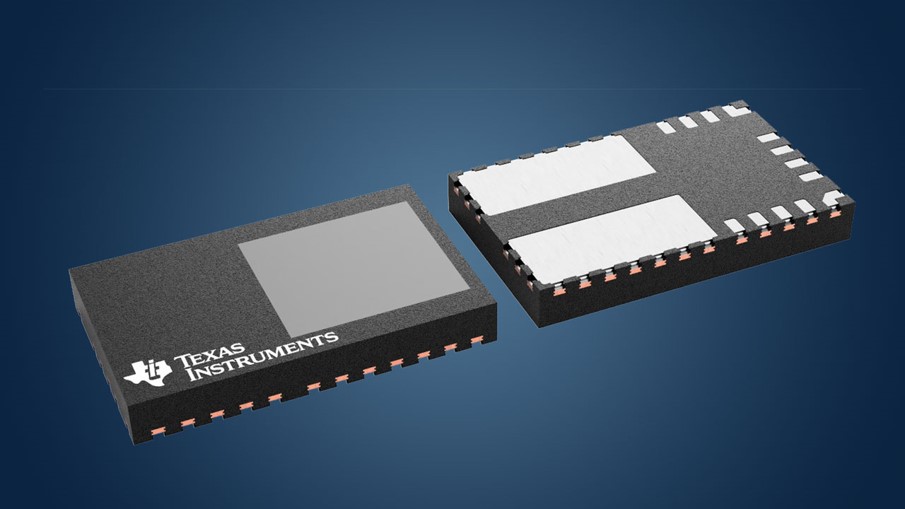 圖 13 采用 15 引腳 very thin quad flat no-lead (VQFN) 封裝的 LMG3100 GaN FET 功率級。GaN 器件采用大型源極和漏極焊盤以及外露芯片來改進熱管理。
圖 13 采用 15 引腳 very thin quad flat no-lead (VQFN) 封裝的 LMG3100 GaN FET 功率級。GaN 器件采用大型源極和漏極焊盤以及外露芯片來改進熱管理。TI 的三相 DRV7308 GaN 智能電源模塊 (IPM) 是另一款基于 GaN 的器件,采用業界通用的 quad flat no-lead (QFN) 12mm x 12mm 封裝,尺寸比同類 250W IPM 小 55%,并且使 PCB 尺寸縮小超過 65%,如 圖 14 所示。
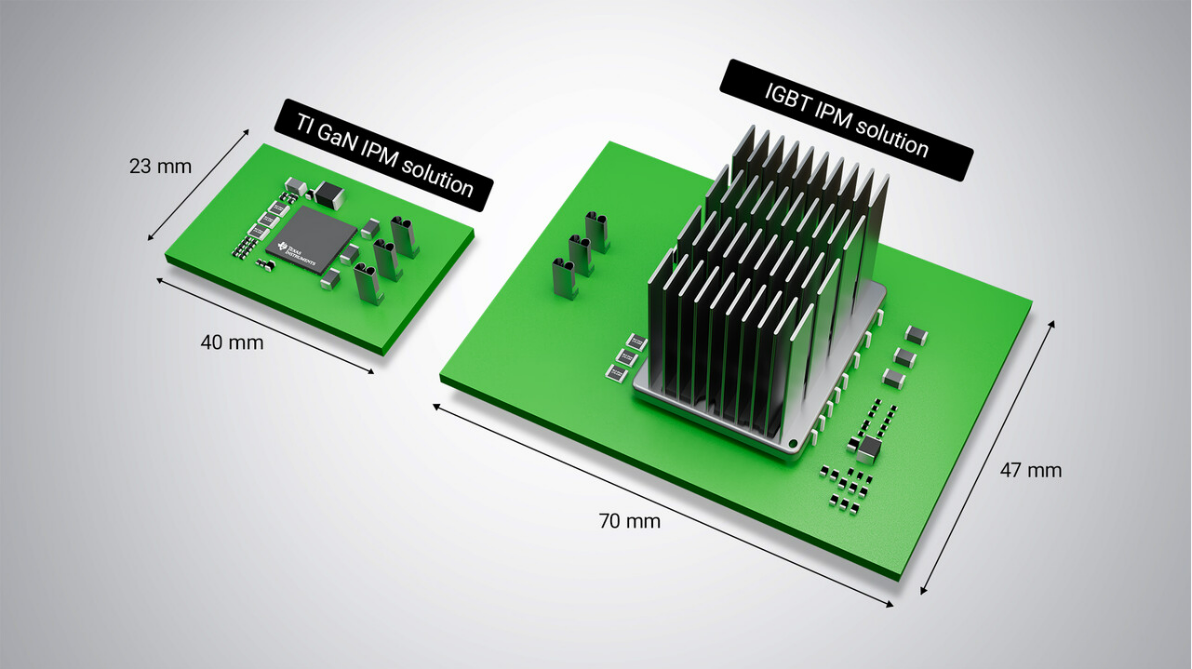 圖 14 DRV7308 GaN IPM PCB 與 250W 絕緣柵雙極晶體管解決方案相比。
圖 14 DRV7308 GaN IPM PCB 與 250W 絕緣柵雙極晶體管解決方案相比。