ZHCAFQ5 September 2025 TMCS1123 , TMCS1123-Q1 , TMCS1126 , TMCS1126-Q1 , TMCS1127 , TMCS1127-Q1 , TMCS1133 , TMCS1133-Q1 , TMCS1143 , TMCS1148
2.2 熱力測試
在初始狀態和完成 500 個溫度循環后,對器件進行了直流熱分析,以評估引線框架在溫度循環應力前后的熱性能。此外,以標準焊盤圖案作為基準對 TMCS 器件進行了相同測試,并在使用免清洗焊膏時對焊盤圖案交叉進行了熱測試。這些電路板中的每一塊上都有 40A 的直流電流流經引線框架并持續 10 分鐘,然后拍攝熱圖像。在所有情況下,這一長度都足夠長,可以讓器件達到熱平衡。
 圖 2-10 SOIC-10 封裝在 SOIC-10 焊盤布局上,初始時刻,SAC 水溶性焊膏
圖 2-10 SOIC-10 封裝在 SOIC-10 焊盤布局上,初始時刻,SAC 水溶性焊膏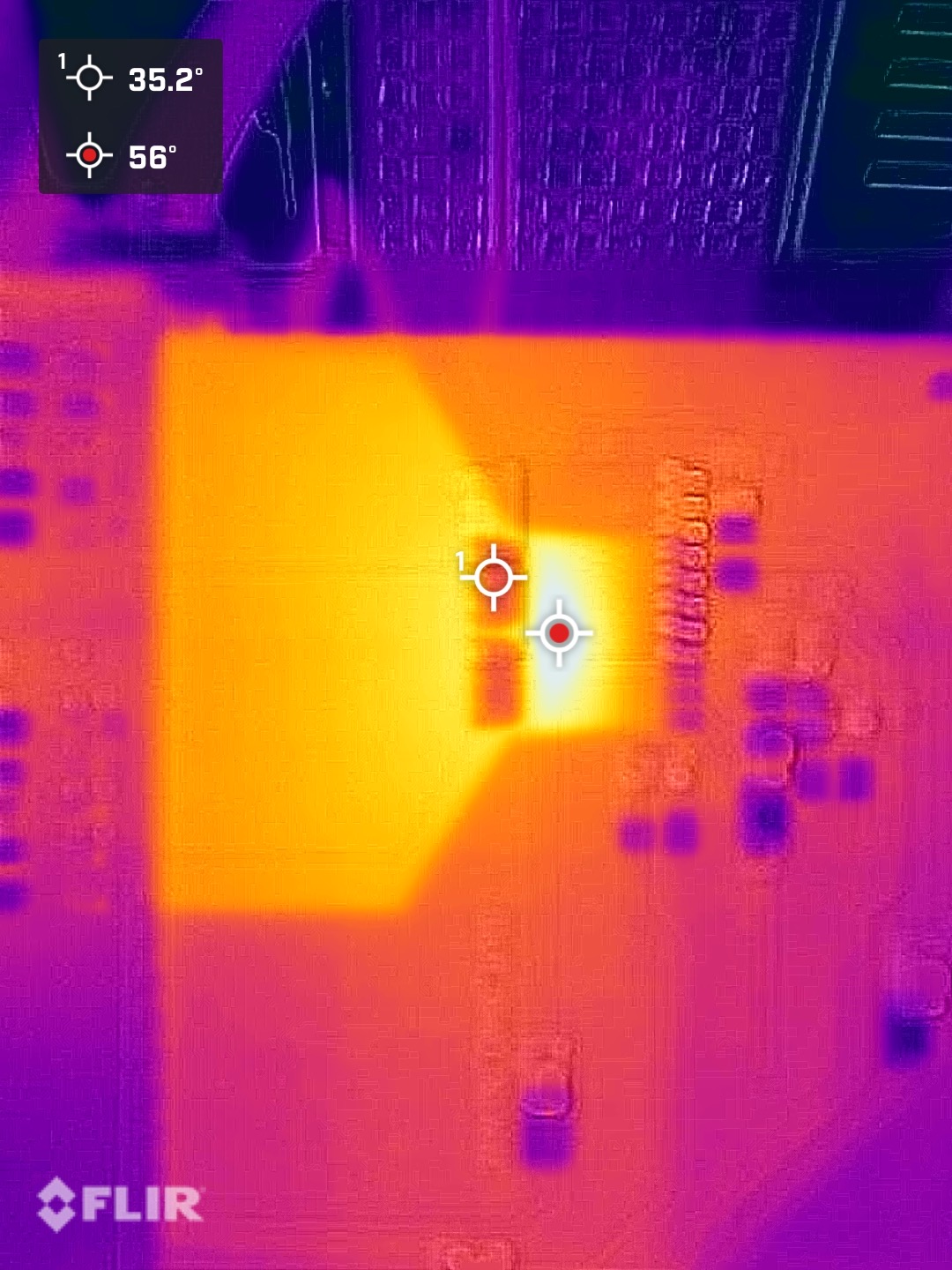 圖 2-11 SOIC-10 封裝在 SOIC-16 焊盤布局上,初始時刻,SAC 水溶性焊膏
圖 2-11 SOIC-10 封裝在 SOIC-16 焊盤布局上,初始時刻,SAC 水溶性焊膏 圖 2-12 SOIC-10 封裝在 SOIC-16 焊盤布局上,500 個循環后,SAC 水溶性焊膏
圖 2-12 SOIC-10 封裝在 SOIC-16 焊盤布局上,500 個循環后,SAC 水溶性焊膏 圖 2-13 SOIC-10 封裝在 SOIC-16 焊盤布局上,初始時刻,SAC 免清洗焊膏
圖 2-13 SOIC-10 封裝在 SOIC-16 焊盤布局上,初始時刻,SAC 免清洗焊膏熱圖像表明,在所有電路板測試中引線框架的溫度都是相近的。從初始測試到 500 個溫度循環后的圖像,最終溫度變化小于 1°C(56°C 與 56.6°C 對比)。相比之下,TMCS 在標準焊盤布局上的基線板的最終溫度為 55°C。使用免清洗焊膏的 SOIC-16 焊盤布局板上的 SOIC-10 也穩定在與其他測試相同的溫度 (56.4°C)。總之,除了預計的隨機工藝變化之外,沒有觀察到明顯的熱變化。