ZHCAA86A October 2020 – February 2021 LMG3422R030 , LMG3422R050 , LMG3425R030 , LMG3425R050
4.1 用于熱分析的有限元模型
為了比較不同表面貼裝封裝的熱性能(即 RθJC/P),已經利用 ANSYS 有限元分析 (FEA) 軟件建立了仿真模型。圖 4-1 所示為 QFN 8x8、QFN 12x12、TOLL 和D2PAK 這四種封裝的模型圖示。前兩種 QFN 封裝用于 TI 的 600V GaN 功率級產品,而后兩種封裝由競爭對手分別用于其商業發布的 600V GaN 和 650V SiC 分立式器件。每個表面貼裝器件均放在一塊 4 層 PCB 的中央,PCB 的表面積為 40mm x 40mm,厚度為 1.58mm。
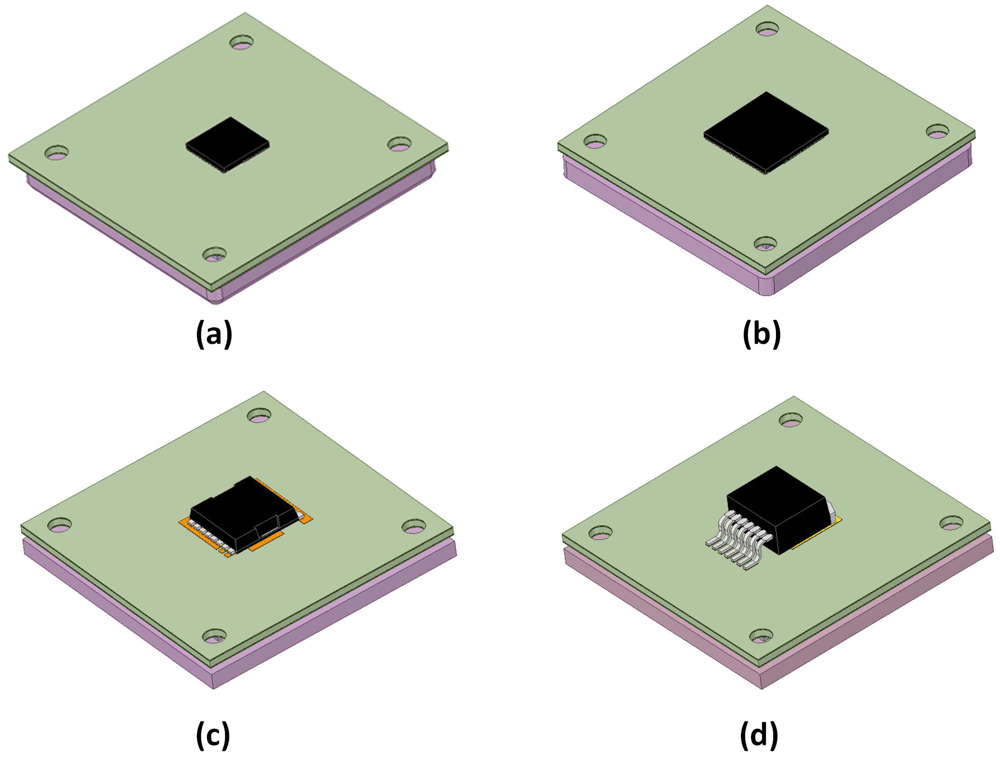 圖 4-1 為不同封裝建立的仿真模型:(a) QFN 8x8,(b) QFN
12x12,(c) TOLL 和 (d) D2PAK
圖 4-1 為不同封裝建立的仿真模型:(a) QFN 8x8,(b) QFN
12x12,(c) TOLL 和 (d) D2PAK圖 4-2 所示為所生成模型的示例橫截面圖并詳細說明了多層 PCB 結構。對于所有已建立的模型,包括散熱過孔樣式設計(圖 4-3)在內的大多數構建元素是相同的,但有兩項除外:PCB 頂部銅層設計和散熱過孔總數,它們已調整為適合每種封裝的散熱焊盤面積,以便公平比較不同封裝之間的熱性能。請注意,用于散熱的頂部銅焊盤和相應的散熱過孔樣式/數量可針對特定應用進行進一步的優化。表 4-1 總結了主要建模組件的關鍵尺寸和熱信息。
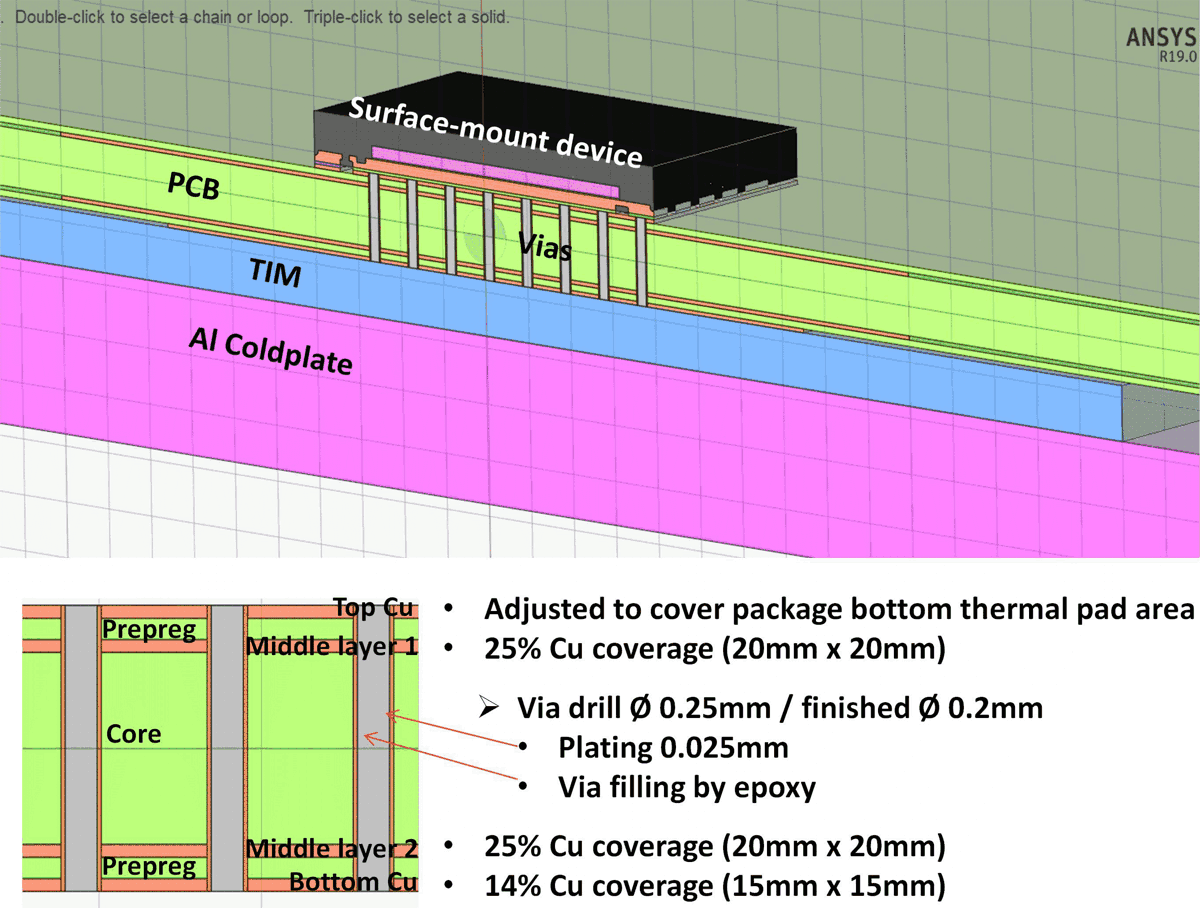 圖 4-2 仿真模型的橫截面視圖 (QFN 8x8)
圖 4-2 仿真模型的橫截面視圖 (QFN 8x8) 圖 4-3 PCB 上的散熱過孔樣式
圖 4-3 PCB 上的散熱過孔樣式表 4-1 仿真模型組件的特性
| 組件 | 厚度 (mm) | 材料 | 熱導率 (W/mK) |
|---|---|---|---|
| 焊料 | 0.05 | 無鉛焊料 | 50 |
| PCB | 0.12(半固化片)/1.06(內核) | FR4 | 0.3 |
| 0.07(4 層) | 銅 | 385 | |
| 散熱過孔 | 0.025 | 鍍銅 | 385 |
| 0.2(直徑) | 環氧過孔填料 | 1 | |
| TIM | 1 | 導熱墊 | 8 |
| 冷板 | 2.5 | 鋁合金 | 160 |