ZHCAA86A October 2020 – February 2021 LMG3422R030 , LMG3422R050 , LMG3425R030 , LMG3425R050
3.1 封裝熱性能參數 RθJC/P 的定義
圖 3-1
描繪了從器件結到環境的兩條平行熱流路徑,并給出了相應的一維熱阻 (Rθ) 電路模型。表 3-1圖 3-1 對 中所示和本報告討論的各種 Rθ
參數進行了說明。底面冷卻的 QFN 12x12 封裝設計為主要通過熱界面材料 (TIM) 以及與環境相連的散熱器從基體 PCB
中散熱。在這種典型的底面冷卻配置中,從封裝頂部散發到環境中的熱量極少。底部路徑的效率越高,從頂部散發的能量就越少。
Equation1因此, 可使用 對一種高效率底面冷卻系統的
RθJA進行估算:
RθJC(bot 或 top),定義為在器件結與封裝表面之間用于散熱的熱阻,通常在制造商的數據表中給出。然而,在某些情況下,使用這個參數直接比較封裝的熱性能會帶來誤導,特別是對于不同類型的封裝。例如,當采用 D2PAK 封裝時,同一個 600V Si MOSFET 的 RθJC(bot) 值可能為 0.8°C/W,但采用 QFN 8x8 封裝時此參數的值為 0.6°C/W,原因在于 D2PAK 具有更厚的銅片。這并不意味著 QFN 8x8 封裝在熱性能方面比 D2PAK 更好。通過增加封裝熱阻 RθJC(bot),在 D2PAK 封裝中使用較厚的銅片進行裸片連接,可以在熱流到達 PCB 頂部銅層之前在封裝內部實現更均勻的熱量分布。此外,熱片較大也使系統設計人員能夠在 PCB 上增加更多的銅焊盤面積和散熱過孔,以降低其熱阻。PCB 上的散熱更有效,因此 RθTIM 會隨之降低。因此,通過提高現有冷卻元件的效率和/或采用更有效的散熱解決方案,在散熱方面設計良好的封裝有助于提供系統級別的功率耗散能力,這一點非常重要。對于底面冷卻的表面貼裝封裝,其熱性能不可避免地與安裝板(以及附著的 TIM,如果使用)相耦合。Equation2為了更好地定義和比較不同封裝的熱性能,在以下章節中使用了一個實用指標 RθJC/P(即從器件結到主冷卻平面的熱阻),其定義請參閱:
Equation2對于此定義, 中不包括 RθH/S 或 RθColdplate,因為它們獨立于器件封裝設計,更多地取決于其自身特性(如材料和結構)和其他使用條件(如空氣/冷卻劑流速)。
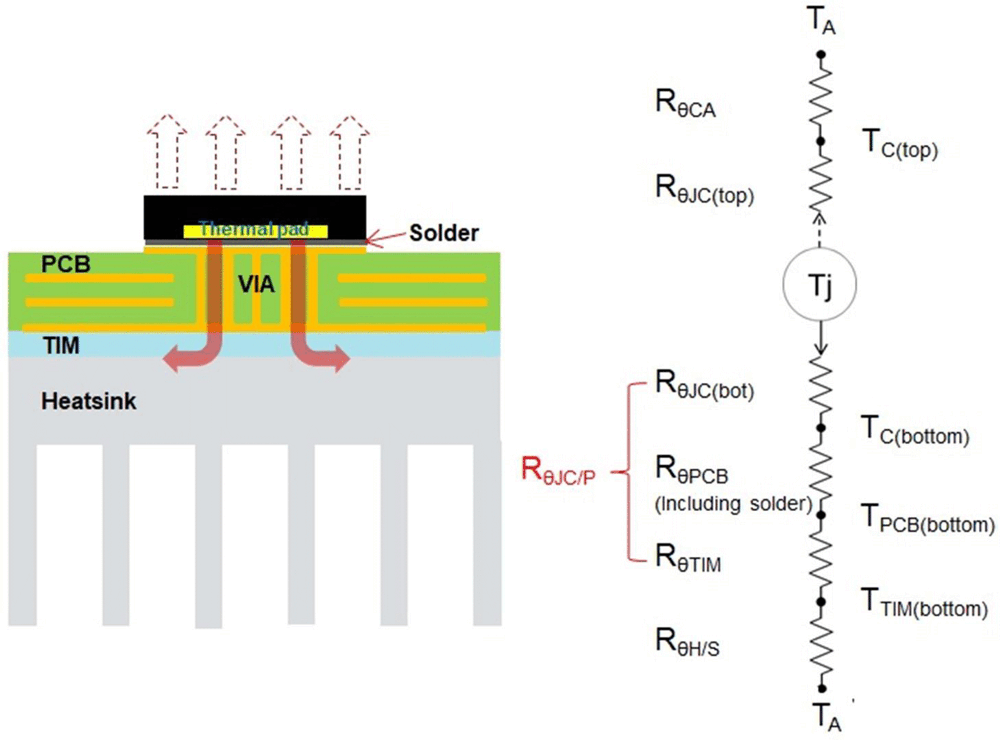 圖 3-1 帶底部散熱焊盤的表面貼裝器件的典型冷卻設計
圖 3-1 帶底部散熱焊盤的表面貼裝器件的典型冷卻設計| 符號 | 說明 |
|---|---|
| RθJA | 結至環境熱阻 |
| RθJC(top) | 結至外殼(頂部)熱阻 |
| RθJC(bot) | 結至外殼(底部)熱阻 |
| RθCA | 外殼至環境熱阻 |
| RθJC/P | 結至冷卻平面熱阻 |
| RθPCB | PCB(包括焊料層)的熱阻 |
| RθTIM | 熱界面材料 (TIM) 的熱阻 |
| RθH/S | 散熱器的熱阻 |