ZHCSJO2F May 2019 – September 2025 TPS7B81-Q1
PRODUCTION DATA
封裝選項
機械數據 (封裝 | 引腳)
散熱焊盤機械數據 (封裝 | 引腳)
訂購信息
7.1.1 功率耗散
電路可靠性需要適當考慮器件功率耗散、印刷電路板 (PCB) 上的電路位置以及正確的熱平面尺寸。穩(wěn)壓器周圍的 PCB 區(qū)域必須盡量消除其他會導致熱應力增加的發(fā)熱器件。
對于一階近似,穩(wěn)壓器中的功率耗散取決于輸入到輸出電壓差和負載條件。可使用 方程式 1 來計算 PD:
需要注意的一點是,通過適當選擇系統(tǒng)電壓軌,可更大限度地降低功率耗散,從而實現更高的效率。通過適當的選擇,可以獲得最小的輸入到輸出電壓差。器件的低壓降有助于在寬輸出電壓范圍內實現出色效率。
器件的主要熱傳導路徑是通過封裝上的散熱焊盤。因此,必須將散熱焊盤焊接到器件下方的銅焊盤區(qū)域。此焊盤區(qū)域包含一組鍍通孔,可將熱量傳導到任何內部平面區(qū)域或底部覆銅平面。
最大功耗決定了該器件允許的最高結溫 (TJ)。根據 方程式 2,功率耗散和結溫通常與 PCB 和器件封裝組合的結至環(huán)境熱阻 (RθJA) 和環(huán)境空氣溫度 (TA) 有關。該公式重新排列后可得到輸出電流(如方程式 3 所示)。
遺憾的是,此熱阻 (RθJA) 在很大程度上取決于特定 PCB 設計中內置的散熱能力,因此會因銅總面積、銅重量和平面位置而異。表中記錄的 RθJA 由 JEDEC 標準 PCB 和銅擴散面積決定,僅用作封裝熱性能的相對測量。請注意,對于精心設計的熱布局,RθJA 實際上是封裝結至外殼(底部)熱阻 (RθJCbot) 與 PCB 銅產生的熱阻的總和。
圖 7-1 至 圖 7-6 展示了 RθJA 和 ψJB 的功能與銅面積和厚度的關系。這些圖是使用 101.6mm × 101.6mm × 1.6mm 兩層和四層 PCB 生成。對于四層板,內部平面使用 1oz 厚度的覆銅。外層均使用 1oz 和 2oz 銅厚度進行模擬。該器件的散熱焊盤下方設有一個 2 × 1 陣列的散熱過孔,這些過孔的鉆孔直徑為 300μm,銅鍍層厚度為 25μm。散熱通孔連接頂層和底層,如果是 4 層板,則連接第一個內部 GND 平面。每一層都有一個面積相等的銅平面。
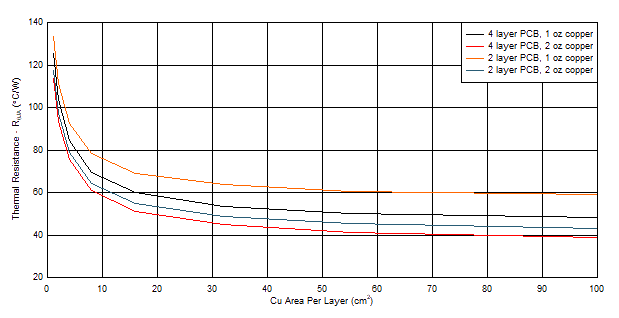 圖 7-1 WSON (DRV) 封裝的 RθJA 與銅面積間的關系
圖 7-1 WSON (DRV) 封裝的 RθJA 與銅面積間的關系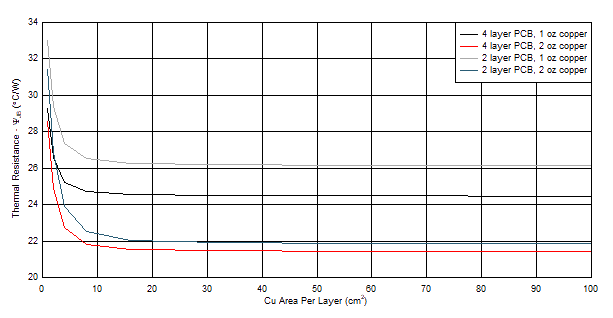 圖 7-2 WSON (DRV) 封裝的 ψJB 與銅面積間的關系
圖 7-2 WSON (DRV) 封裝的 ψJB 與銅面積間的關系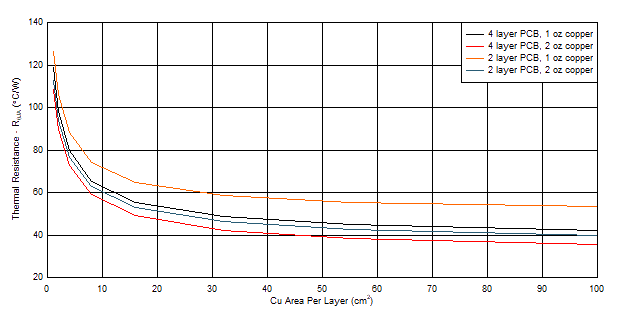 圖 7-3 HVSSOP (DGN) 封裝的 RθJA 與銅面積間的關系
圖 7-3 HVSSOP (DGN) 封裝的 RθJA 與銅面積間的關系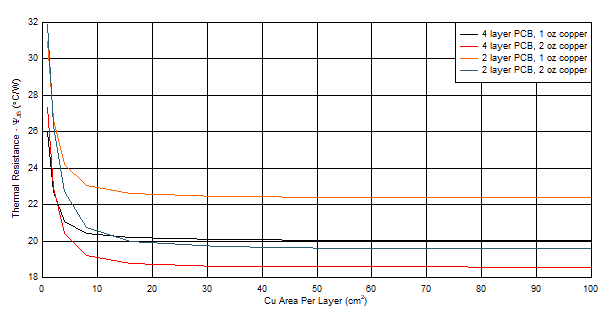 圖 7-4 HVSSOP (DGN) 封裝的 ψJB 與銅面積間的關系
圖 7-4 HVSSOP (DGN) 封裝的 ψJB 與銅面積間的關系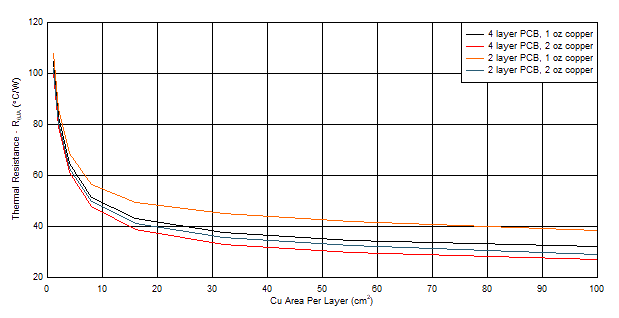 圖 7-5 TO-252 (KVU) 封裝的 RθJA 與銅面積間的關系
圖 7-5 TO-252 (KVU) 封裝的 RθJA 與銅面積間的關系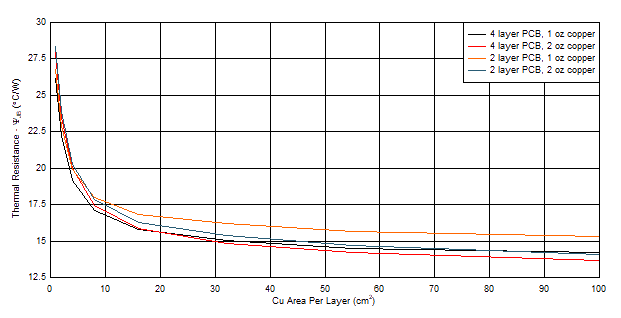 圖 7-6 TO-252 (KVU) 封裝的 ψJB 與銅面積間的關系
圖 7-6 TO-252 (KVU) 封裝的 ψJB 與銅面積間的關系