ZHCAB20 November 2020 LM61460-Q1 , LM63615-Q1 , LM63625-Q1 , LM63635-Q1 , LMR33620-Q1 , LMR33630-Q1
4 封裝類型
封裝類型對熱性能具有重大影響。在下面的討論中,封裝分為兩大類:底部有裸片附接焊盤 (DAP) 的封裝和底部無 DAP 的封裝。當然,不同封裝之間還有更多的區別和其他重要功能的差異,但從散熱角度來看,這一區別最為重要。例如,LMR33630 可同時采用 HSOIC 和倒裝芯片(或 HotRod?)QFN 封裝,如圖 4-1 所示。
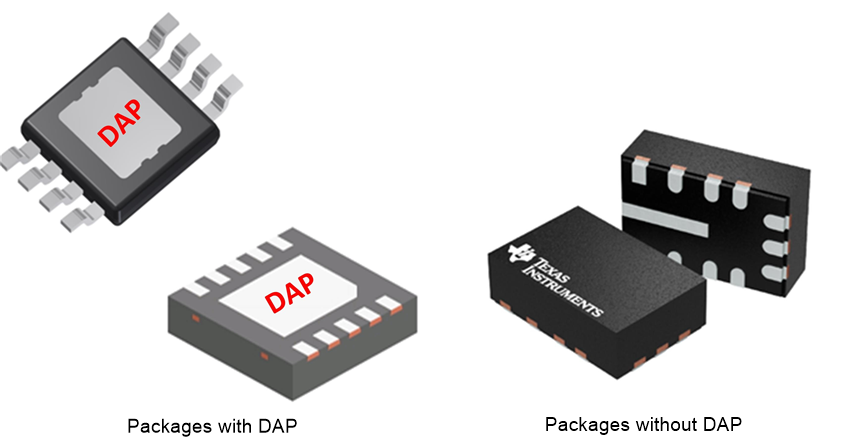 圖 4-1 LMR33630-Q1 封裝類型.
圖 4-1 LMR33630-Q1 封裝類型. 對于該系列器件,圖 4-2 顯示了兩種封裝之間 θJA 的差異。這些值基于 JEDEC 標準板,很明顯,HSOIC 封裝的熱阻低得多。不利之處也是顯而易見的;在本例中,HSOIC 封裝的面積是倒裝芯片 QFN 面積的三倍以上。與完全暴露引腳的較大封裝相比,將 QFN 封裝組裝到 PCB 時需要更加小心。圖 4-3 和圖 4-4 幫助解釋了這兩個示例封裝之間的熱阻差異。HSOIC 具有一個直接附接到穩壓器裸片的大金屬散熱板(即 DAP)。相應地,DAP 被焊接到 PCB 銅散熱器上。這提供了從裸片(熱發生器)到散熱器和外部環境的一種非常低的熱阻路徑。因此,大約 80% 的熱量流經 DAP,20% 流經引線,而極少的熱量流經塑料。這使得 DAP(通常為電氣接地)下的銅能夠非常有效地散去封裝中的熱量。
使用倒裝芯片封裝時,裸片(或基板)背面朝上,遠離 PCB。到 PCB 的唯一金屬連接是通過封裝引腳實現的。這迫使熱量通過一種非常受限的路徑流動,并會增加有效熱阻。這還表明,到引腳的銅路徑應盡可能發揮作用,以便充當散熱器。對于直流/直流轉換器而言,VIN、GND 和 SW 引腳在散熱方面最為有效,應使其較寬。
當然,這些只是設計人員可用的電源封裝類型的兩個示例。TI 提供的許多封裝類型同時具有良好的熱性能和小尺寸優點。例如,符合汽車類標準的 LM63635-Q1。該器件采用 3.00mm x 3.00mm 的小型 WSON 封裝,帶有 DAP;可提供與大得多的封裝相當的性能。
請注意,JEDEC 標準板過于強調了倒裝芯片 QFN 和 HSOIC 之間的差異。在許多實際應用中,這兩種封裝之間的總 θJA 值是可以相比的。倒裝芯片 QFN 與帶有 DAP 的封裝相比,將需要更多的 PCB 銅面積。在任何情況下,如前所述,表中給出的 θJA 值不會用于設計目的。
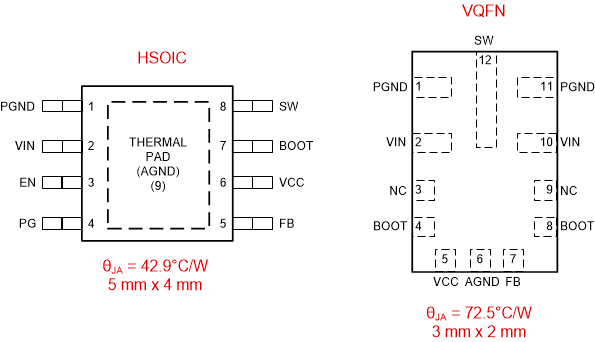 圖 4-2 HSOIC 和 VQFN 封裝性能比較.
圖 4-2 HSOIC 和 VQFN 封裝性能比較. 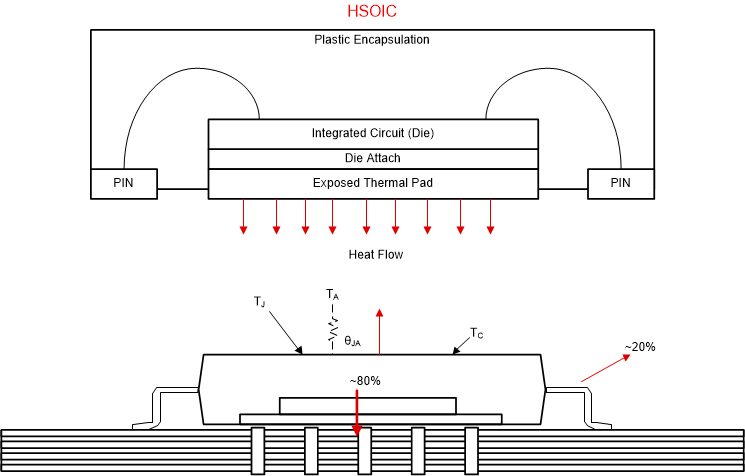 圖 4-3 HSOIC 封裝中的典型熱流.
圖 4-3 HSOIC 封裝中的典型熱流. 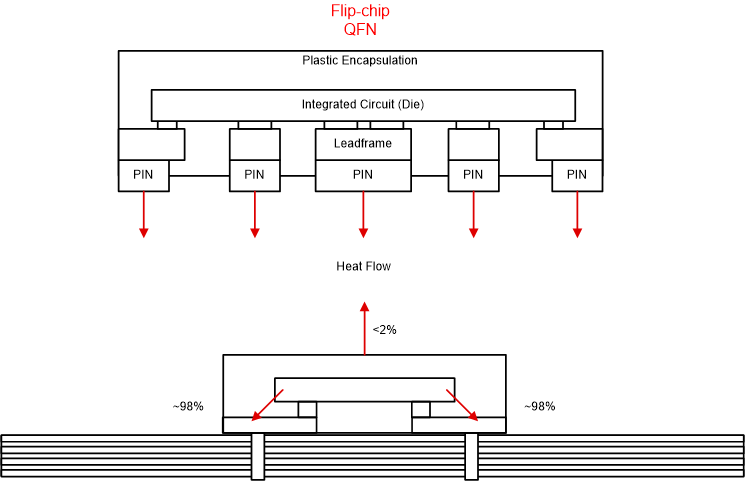 圖 4-4 VQFN 封裝中的典型熱流.
圖 4-4 VQFN 封裝中的典型熱流.